
 | |
|
Главная
>
Радитехнология низких температур
0,75 Unn.e Рис. 2.14. Вольтамперные характеристики германиевых СВЧ диодов с областью отрицательной проводимости при температуре жидкого гелия. Стрелками обозначен ход кривых при увеличении и уменьшении U. фузионных диодов при Г = 4,2°К на прямой ветви вольтамперной характеристики также возникает область с отрицательным наклоном (рис. 2.14). Это явление в основном обусловлено ударной ионизацией в базовой области диода, представляющей собой сильнолегированный и компепсироваршый германий. Как известно, использование такого явления в монокристаллах германия с омическими контактами на торцах кристалла привело к созданию одного из перспективных элементов двоичной техники - криосара. Весьма возможно, что сочетание в одном приборе СВЧ диода и криосара может дать дополнительный эффект. Ввиду того, что из перечисленных материалов арсенид галия GaAs обеспечивает требуемые ха- Т--300  Рис. 2.15. Осциллограмма вольтампер-ных характеристик туннельного днода ыа базе GaAs при Т= = 300 и 77° К. рактерпстпкп не только при заданной температуре охлаждения, но и в широком интервале температур, рассмотрим более подробно свойства параметрических СВЧ диодов на базе GaAs. Характерные температурные зависимости для отечественных туннельных диодов из арсенида галлия изображены на осциллограмме рис. 2.15. 3. ОХЛАЖДАЕМЫЕ ПАРАМЕТРИЧЕСКИЕ ДИОДЫ ИЗ АРСЕНИДА ГАЛЛИЯ С целью определения критерия пригодности полупроводникового материала для параметрического диода ПД (варактора) рассмотрим величину максимальной добротности диода Рмакс, определяющую основные характеристики охлаждаемого устройства (например, параметрического усилителя ПУ). Для случая резкого перехода на однородной базе величина Qmbkc может быть достаточно просто связана с электрофизическими параметрами полупроводникового материала и р-п перехода (см. § 2): Qmkkc - со (2.43) те К-коэффициент, определяемый геометрическими размерами активной области диода. Учитывая, что обычно f/np > U, будем в дальнейшем при сравнении материалов пользоваться уставным критерием \ (2.44) Широко применяемый в литературе критерий (7) недостаточно точно характеризует пригодность данного полупроводника для создания варакторов, так как не отражает тех ограничений, которые налагают необходимость обеспечения определенпой величины f/np- Как видно из выражения (2.44), подходя1цим материалом для ПД может считаться полупроводник с высо- - 95 - кими значениями ц и низкой е при обеспечении достаточно большой величины t/np. Для заданного материала в целях повышения Смаке ВЫГОДНО увеличивать N. Кроме того, с ростом Л, как будет показано ниже, увеличивается работоспособность ПД при криогенных температурах. Однако с возрастанием N падает Unp, минимально необходимая величина которого и ограни- ТАБЛИЦА 2.3
* тт - относительная эффектитная масса электрона. ** Для InSb С р~(4+е)в. чивает по максимуму для каждого из полупроводниковых материалов. Поэтому сравнение материалов по критерию П [см. (2.44)] будем проводить при одинаковом значении (7шр. Электрический пробой р-п перехода ограничивает допустимое значение отрицательного напряжения на ПД. При пробое минимальная энергия электрона, необходимая для образования пары электрон-дырка, должна превышать энергию, соответствующую ширине запрещенной зоны АЕ. Как видно из табл. 2.3, из сравниваемых материалов арсенид галлия GaAs обладает наибольшей ширниоп запрещенной зоны. Критическая напряженность поля в переходе Е для Gay\s (~500 кв/см [29]) в несколько раз превышает напряженность для Ge (80-90 кв/см [6]) и того же порядка, что и для Si. В диоде с однородной базой и резким переходом легко связать значение Unp с величиной концентрации свободных носителей заряда, исходя из ширины запорного слоя при пробое макс - (f/K-t/тгр) (2.45) И учитывая, что для резкого перехода (2.46) Из уравнений (2.45) и (2.46) при [/пр > f/к получаем (2.47) е Е 2е -дГ Из уравнения (2.47) легко видеть, что более высокое значение £кр для арсенид-галлневых переходов позволяет при обеспечении тех же 6пр использовать материалы с большей, чем для других полупроводников, концентрацией носителей. Поэтому было бы ошибочным сравнивать критерии качества различных полупроводниковых материалов при одинаковых Л. Интересно отметить, что с учетом уравнения (2.47) критерий П с точностью до постоянной примет вид П=ц£ р. (2.48) В табл. 2.3 приведены значения N для и-типа GaAs, Ge и Si из условия получения в диоде с однородной базой f/iip= Ю е. При расчете использованы известные эмпирические зависимости Unp=f{N): для GaAs и Si [39] для Ge[40] t/np=10 .yV-o.3. [/np=il,03- lOsyv-o.aS; (2.49) (2.50) где f/пр измеряется в вольтах. N - в см-. Эти выражения учитывают зависимость Е р от N (с ростом концентрации возрастает £ р) и, естественно, отличаются от общего уравнения (2.47). Температурная зависимость [/ р для GaAs [29], так же как и для Ge и Si, описывается уравнением (2.25). Коэффициент Рд примерно одинаков для всех трех материалов. С. ростом концентрации носителей убывает. Поэтому у низковольтных диодов температурный коэффициент пробивного напряжения меньше, чем у высоковольтных-7-2175 - 97 - Как видно из уравнений (2.44) и (2.48), критерий П существенно зависит от подвижности основных носителей заряда. Учитывая более высокую подвижность электронов по сравнению с подвижностью дырок, в ПД в качестве материала базы, определяющей величину сопротивления растекания, желательно использовать полупроводники электронного типа. Отметим, что при рассмотрении диффузионных диодов, имеющих р-область конечной толщины, для диодов из GaAs, и особенно из InSb, влияние этой области на становится заметным по сравнению с влиянием г,-области. Если в Si и Ge при одной концентрации подвижность электронов превосходит подвижность дырок не более чем в 2-3 раза, то в GaAs соответствующее отногпение подвижностей составляет около 14, а в InSb - около 80. Это вызывает необходимость в последних двух случаях ограничивать р-область в диффузионных диодах для оптимизации параметров диодов, а в случае InSb может даже заставить отказаться от применения диффузионных диодов в пользу диодов с резким переходом. Зависимость параметра {ТУ диодов из GaAs, Ge и Si с резким переходом и однородной базой, рассчитанная по известным данным и формулам (2.49) и (2.50), приведена на рис. 2.16. Как .показано в предыдущих разделах, для того, чтобы деионизация примесей в полупроводнике наступила только при очень низких температурах, энергия ионизации примесей IF,- должна быть минимальной. Энергия ионизации доноров в GaAs и InSb значительно ниже, чем в Ge и Si (см. табл. 2.3), и они сохраняют достаточно высокую примесную проводимость при низких температурах при сравнительно более низких концентрациях примеси, обеспечивающих высокие значения Unp в диодах. В области криогенных температур большую роль в механизме проводимости играет образование примесных зон, имеющее место и в моноатомных полупроводниках, но особенно ярко проявляющееся в полупроводниковых соединениях электронного типа. Взаимодействие между примесями, формируюпее примесную зону, тем больше, чем меньше эффективная масса носителей и чем выше концентрация примесей [42]. Поэтому в соединениях с малой эффективной массой (таких, как InSb и GaAs типа; см. табл. 2.3) примесные уровни перекрываются с зоной проводимости при сравнительно низкой концентрации примесей. В Si, Ge или GaAs р-типа это происходит лишь при более высокой концен- 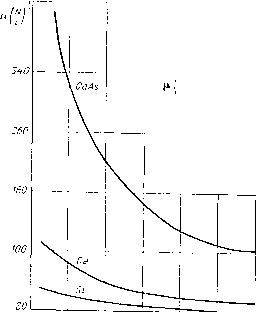 Рис. 2.16. Зависимость параметра N У ~) от t/np ДЛЯ различных полупроводниковых диодов. о О го 30 40 50 Una. трации примесей (менее пригодной для создания высоковольтных диодов). Для Электронного GaAs энергетический зазор между примесной зоной и зоной проводимости при низких температурах даже при iV 105-10 см~ составляет лишь 0,001-0,003 эв [43, 44]. Сравнивая полупроводниковые материалы при значениях концентраций примесей, обеспечиваюгцих получение достаточно высоких Ущ, в диодах, можно отме-
|
|||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||