
 | |
|
Главная
>
Радитехнология низких температур тигь, что в то время как в электронном GaAs в интервале температур от 300 до 2° К концентрация ионизированных примесей меняется не больше чем в 2-3 раза, в Ge и Si она меняется на несколько порядков [44 и 7, гл. 1]. В примере, приведенном в табл. 2.3 (f/np=10 в), указана температура, при которой р полупроводникового материала (а следовательно, и сопротивление потерь диода, изготовленного на этом материале) возрастает примерно в два раза (Ti) и в 10 раз (Гг) по сравнению с р при комнатной температуре (данные зависимости р==р (Г) для Ge и Si [7, гл. 1]). Для Si, Ge и GaAs температура Ti соответственно составляет около 65, 30 и 2° К. Следует отметить, что количественное сравнение характеристик ПД из различных материалов целесообразно делать в равных условиях (для структуры перехода и базы). Так, например, упоминавшийся в § 2 кремниевый диффузионный диод был выполнен по уникальной технологии, которая позволила свести базовую область к минимуму при (7пр, равном всего 4 е. В данном случае образование примесной зоны маловероятно и процесс проводимости можно объяснить эффектом перескока носителей между примесными уровнями. Необходимым условием возможности проявления такого эффекта является наличие компенсирующей примеси. Наличие примесной зоны приводит к уменьшению температурной зависимости ц так как при низких температурах полная проводимость определяется проводимостью в примесной зоне, подвижность носителей в которой слабо зависит от температуры. Значение ц в примесной зоне много меньше .и в зоне проводимости. Однако с увеличением концентрации примесей подвижность электронов в примесной зоне растет и максимум кривой n=ii{T) становится слабо выраженным [42]. Значение ц в примесной зоне у GaAs /г-типа благодаря малой эффективной массе электронов (табл. 2.3) сохраняется достаточно высоким. Зависимость р (Г) связана с обеими зависимостями: N = N{T) и .i = (i(7). При понижении температуры р проходит через минимум и далее возрастает особенно резко в тех случаях, когда примесная зона не образуется. Приборы на основе GaAs использовались во многих случаях при температурах жидкого гелия и, судя по характеристикам самого материала, могут работать даже при температуре порядка Г К. Вольтфарадная характеристика параметрических диодов на основе GaAs при охлаждении до температуры жидкого гелия оставалась неизменной, однако значение критической частоты, а следовательно, и добротности диодов уменьшалось в 3 раза по сравнению с таковой при 80°К (как предполагалось, из-за уменьшения подвижности носителей [46]). Рассмотрим более подробно температурные характеристики арсенида галлия GaAs. Зависимость (Г) для GaAs /г-типа с концентрацией Л = 4-105-5 10 сж- в интервале температур 2-300°К приведена на рис. 2.17, зависимость р и N от Г-на рис. 2.18. Эти зависимости построены по данным работ (45, 37]. Характер указанных зависимостей свидетельствует о наличии примесной зоны. По мере снижения температуры примеси деионизуются, концентрация свободных носителей вначале падает, проходит через минимум, а затем медленно возрастает за счет переноса электронов между примесными состояниями. В соответствии с изменением N=N{T) удельное сопротивление проходит через минимум при 7<300° К, затем возрастает вначале быстро, потом медленно. Образцы обнаруживают проводимость в примесной зоне при температуре ниже 55° К {45], и по мере снижения Т эта проводимость проявляется все сильнее. Зависимость Цп = 1х{Т) в интервале температур 60-300° К носит обычный характер и имеет максимум при температурах тем более высоких, чем больше N. В области, где сказывается примесная проводимость, 1 продолжает падать с уменьшением температуры, так как подвижность носителей в примесной зоне значительно меньше подвижности в зоне проводимости. Однако ввиду небольшой зависимости подвижности в примесной зоне от температуры холловская подвижность в интервале температур ниже 55° К пропорциональпа Г , а при температурах ниже 10° К практически постоянна. Чем выше концентрация, тем меньше изменение параметров с температурой: если при ЮЗ--- Ю сж-з значение р меняется на один-два порядка, то при Л>5-10б см- значения р и ц меняются не более чем в 3 раза, а при /V 5-107 сж-з это изменение не превышает 20-30%, причем в области криогенных температур параметры материала практически постоянны. Очевидно, для охлаждаемых диодов желательно применять исходный материал электронного типа веек 
1 Z 3 if 6 810 2030W 60 100 200300 TfK Рис. 2.17. Низкотемпературная зависимость подвижности электронов в GaAs от Т при различной концентрации примесей: Л 2, 3, 4, 5 - номера образцов. С N>10 см-. Необходим материал нескомпенсирован-ный, поскольку х снижается пропорционально суммарному содержанию примесей и, кроме того, в компенсированных образцах обнаружена более сильная зависимость параметров от температуры [44, 45]. В дырочном GaAs характер температурных зависимостей параметров аналогичен рассмотренному выше. Однако так как эффективная масса дырок примерно на порядок выше эффективной массы электронов, то сопоставимое влияние проводимости в примесной зоне GaAs р-типа будет при концентрациях примесей на 2-3 порядка больше, чем в GaAs п-типа [42]. 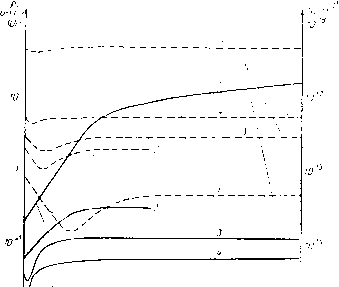
 Рис. 2.18. Зависимость р и от 1/Г в GaAs при концентрации примесей от 4 lOs до W см-. При использовании приведенных в настоящем разделе данных для расчета температурных зависимостей параметров диодов надо учитывать, что нами рассматривались значения холловской подвижности. Эти значения превышают значения дрейфовой подвижности, Имеющей место в приборах, особенно в области ниЗКих температур, где действует механизм рассеивания носителей на примесях. Можно предположить, что вследствие низкой эффективной массы электронов разница в величинах указанных подвижностей для GaAs л-типа невелика, а для GaAs р-типа того же порядка, что для дырочных Ge и Si. Расчет и измерение температурных характеристик в интервале от 2 до 300°К параметрических точечных и диффузионных диодов из GaAs показывают, что при оптимальном выборе параметров полупроводника их характеристики мало изменяются в широком интервале температур, что позволяет обеспечить низкие шумовые температуры охлажденных входных устройств. 4. ТРАНЗИСТОРЫ ПРИ НИЗКИХ ТЕМПЕРАТУРАХ Создание транзисторов, обеспечивающих необходимые параметры при глубоком охлаждении, позволяет решить целый ряд весьма важных задач в радиотехнике. Прежде всего открывается возможность разработки стабильных малошумящих широкополосных предварительных усилителей промежуточной частоты (ПУПЧ) для приемников диапазона СВЧ с применением криогенной техники. Применение охлажденных ПУПЧ на транзисторах, помимо возможного снижения уровня собственных шумов благодаря охлаждению, обеспечивает оптимальное согласование ПУПЧ с охлажденным СВЧ смесителем, так как их можно будет конструктивно совместить в одном узле и исключить промежуточные соединительные кабели. Размещение усилителей или маломощных генераторов на транзисторах-в охлажденном высокочастотном блоке при строго постоянной температуре жидкого азота или жидкого гелия устраняет один из основных недостатков транзисторов - зависимость их параметров от температуры. Большой интерес представляет создание транзисторных схем, позволяющих управлять переключающими элементами и ячейками .памяти, основанными на низкотемпературных эффектах. Из сказанного выше ясно, что исследование свойств и параметров серийных транзисторов в условиях низких температур и разработка новых транзисторных устройств с улучшенными параметрами за счет о.члаж-дения является сейчас одной из актуальных задач. Представим, как обычно транзистор в виде трех слоев полупроводника (например, р-п-р), предположив, что малая толщина обоих р-п переходов и базы позволяет пренебречь .происходящими в них процессами рекомбинации. Ввиду того, что р-п переходы являются основной частью транзистора, весь изложенный ранее материал по исследованию свойств р-п переходов при низких температурах полностью относится и к охлажденным транзисторам. Остановимся на некоторых специфических особенностях транзисторов, проявляющихся при охлаждении. С учетом сделанных замечаний, в первом приближении выразим ток эмиттера (2.51) где U-je - напряжение между эмиттером и базой; Р - коэффициент нелинейности вольтамперной характеристики, зависящий от Т (§2). Концентрация инжектированных в базу дырок при данном значении боб и понижении температуры может сильно меняться. Это видно из анализа температу])ной зависимости концентрации неравновесных неосновных носителей (дырок) ро на границе р-п перехода, для которой справедливо следующее выражение Нелинейность вольтамперной характеристики перехода эмиттер - база при понижении температуры должна резко возрасти, если коэффициент р = const или стремится к 1. Естественно, что для подавления увеличивающейся при охлаждении контактной разности потенциалов перехода (§ 1) необходимо подать на базу некоторое дополнительное постоянное напряжение прямого смещения. Ток коллекторного р-п перехода, включенного в запорном направлении, при разомкнутой цепи эмиттерд ц
|
||||||||||||||||||||||||||